
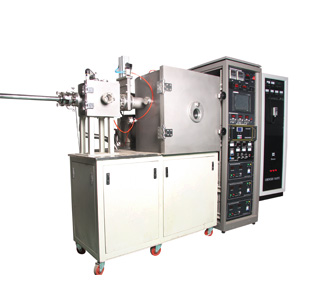
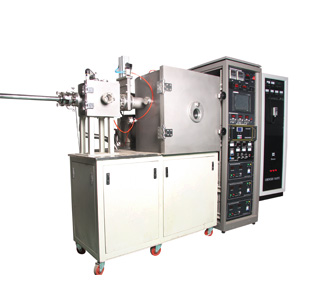
高真空多靶镀膜系统 JCPY500
溅射室:8.0×10-5Pa(空载,经烘烤除气后);
工作方式:各靶可独立/顺次/共同工作,采用磁控靶从上向下溅射镀膜;
脉冲偏压:-1000V,1套;
溅射室:8.0×10-5Pa(空载,经烘烤除气后);
工作方式:各靶可独立/顺次/共同工作,采用磁控靶从上向下溅射镀膜;
脉冲偏压:-1000V,1套;
一.整机简述:
1.特点/用途 | 系统主要由进样室、溅射室、永磁磁控溅射靶、脉冲偏压电源、样品台、样品台加热、真空系统、真空测量系统、气路系统、PLC+工控机+液晶屏全自动控制系统等组成。该设备操控方便;结构紧凑,占地面积小。 本系统适用于纳米量级复合膜、多层膜等制备;适用于三靶单独溅射、依次溅射、共同溅射;可溅射磁性材料;适用于制备金属膜、合金膜、半导体膜、陶瓷膜等。 基于该设备,离子源清洗装置在Load-lock室,样品先经过清洗,在由送样系统传递到真空溅射腔室,进行下一步的溅射镀膜。 |
二.设备主要技术参数: | |
1.真空溅射腔室 | Ф500×H500mm(以最终设计为准),304优质不锈钢制造,双层水冷结构; |
2.Load-lock室 | 配有Load-Lock系统,样片室中的气缸驱动式机械手,完成自动/手动送样/取样过程,可负载2组样品。 |
3.真空系统 | 溅射室:涡轮分子泵+旋片式机械泵+高真空阀门组合的高真空系统,数显复合真空计; Load-lock室:涡轮分子泵+旋片式机械泵+高真空阀门组合的高真空系统,数显复合真空计; |
4.真空极限 | 溅射室:8.0×10-5Pa(空载,经烘烤除气后); Load-lock室:8.0×10-5Pa(空载,经烘烤除气后); |
5.漏率 | ≤0.8Pa/h; |
6.抽速 | 溅射室:(空载)从大气抽至4.0×10-4Pa≤30min; Load-lock室:从大气抽至1.0×10-3Pa≤20min; |
7.基片台尺寸 | Φ120mm范围内可装卡各种规格基片; |
8.基片台旋转、加热 | 基片旋转:0~30转/分钟; 加热:室温~500±1℃,可控可调,日本岛电PID智能温控闭环控温; |
9.溅射靶 | 配置3套3英寸永磁共焦磁控溅射靶(溅射靶角度、高度可调), 磁控靶RF、MF、DC兼容,可以溅射铁磁性材料, 磁控靶配有气动挡板结构;
|
10.工作方式 | 各靶可独立/顺次/共同工作,采用磁控靶从上向下溅射镀膜; |
11.清洗离子源 | Load-lock室:配备有一套离子源清洗功能,可以对样品进行预清洗;电源:考夫曼离子源; |
12.脉冲偏压 | -1000V,1套 |
13.膜厚不均匀性 | ≤±5%(基片台Φ100mm范围内); |
14.溅射室腔体加热 | 可实现溅射室内环境加热,加热温度室温~300℃; |
15.控制方式 | PLC+工控机+液晶屏全自动控制方式;完善的逻辑程序互锁保护系统; |
16.报警及保护 | 对泵、电极等缺水、过流过压、断路等异常情况进行报警并执行相应保护措施;完善的逻辑程序互锁保护系统。 |
17.占地面积 | (主机)L3000×W1000 (㎜) |
Products
研博产品中心
联系人:
销售经理:138 1165 4101
销售经理:136 0112 5769
售后服务:139 1020 6846





